マイクロマシンの製造工程、および各工程で使用するサムコの装置をご紹介します。


フォトリソグラフィー

Siのエッチング
シリコン深掘り装置

フォトレジストの除去
プラズマクリーナー

酸化層(SiO2犠牲層)
エッチング
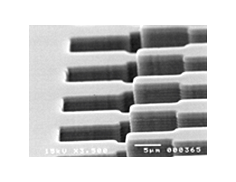
MEMS
サムコ製装置における
MEMSの作製事例
MEMS液体クロマト
グラフィーチップ
深さ30μmの異なるサイズのピラ―の形成が実現している。
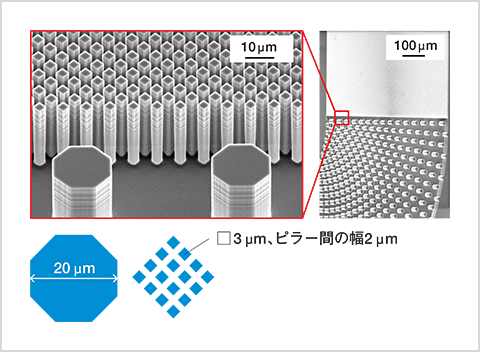
出典
K. Takatsuki, M. Isokawa, Y. Song, A. Nakahara, D. H. Yoon, T. Sekiguchi, J. Mizuno. T.Funatsu, M. Tsunoda and S. Shoji "MEMS LC Microchip with Low Dispersion and Low Pressure Drop Turn Structure Using Distribution Controlled Micro Pillar Array" P981-P984, MEMS 2013, Taipei, Taiwan, January 20-24, 2013
- 提供
- 早稲田大学 庄子研究室
MEMS液体光チョッパ
Silicon on Glass構造においてノツチを最小限に抑制した加工を実現している。
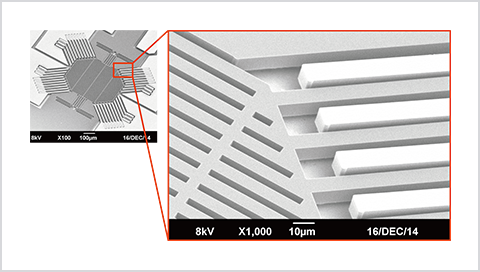
出典
Y. Kogita, Y. Hirai, 0. Tabata, T. Tsuchiya Double-side-drive electrostatic optical chopper for time-resolved raman spectroscopy The 2014 International Conference on Optical MEMS and Nanophotonics (OMN 2014), Glasgow, Scotland (17-21 Aug. 2014), pp.65-66
- 提供
- 京都大学ナノ・マイクロシステム研究室 田畑教授 土屋准教授
京都大学ナノテクノロジーハブ拠点 MEMS用高速シリコンエッチング装置
Samco RIE-800iPB-KUにて加工
※ナノハブは、内外の研究者の研究を支援する役割を持った開かれた施設として運営されています。