TSV(Through-Silicon Via)の製造工程、および各工程で使用するサムコの装置をご紹介します。
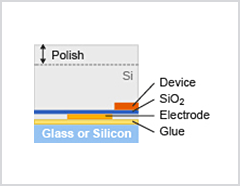
CMPによるSiの研磨
(Chemical Mechanical Polishing)

フォトリソグラフィー

貫通孔の形成
ボッシュプロセスによりSiをエッチングし貫通孔を形成
シリコン深掘り装置

側壁への絶縁膜形成
貫通孔の側壁にTEOS-SiO2絶縁膜を形成
液体ソースCVD®装置

下部電極露出
電極上のTEOS-SiO2を選択的に除去
RIE装置

バリア層の形成
TiNバリア層によりCuの拡散を防止

メッキによる
Cuプラグの形成

CMP

RIEによるCuプラグ出し
RIE装置

SiO2膜の形成
液体ソースCVD®装置

フォトリソグラフィー

SiO2膜のエッチング
RIE装置
サムコ製装置における
TSVの作製事例
埋め込み特性
SIPスパッタによるシードCu膜厚:310nmの導入とめっき条件の最適化により低温プラズマCVD膜を1.36μm形成後でも高アスベクト比ビア(~7)への銅の完全充填が可能 。