サムコで取り扱っている
ICPエッチング装置
放電形式に誘導結合プラズマ(Inductively Coupled Plasma)を採用しており、高密度プラズマを安定して生成し、高精度の加工が可能です。
-

ICPエッチング装置 RIE-800iPC
フラッグシップ真空カセットモデル
-

ICPエッチング装置 RIE-800iP
フラッグシップロードロックモデル
-

ICPエッチング装置 RIE-400iP
化合物半導体用省スペース装置
-

ICPエッチング装置 RIE-400iPC
化合物半導体用真空カセット装置
-

ICPエッチング装置 RIE-230iP
実績豊富な汎用装置
-
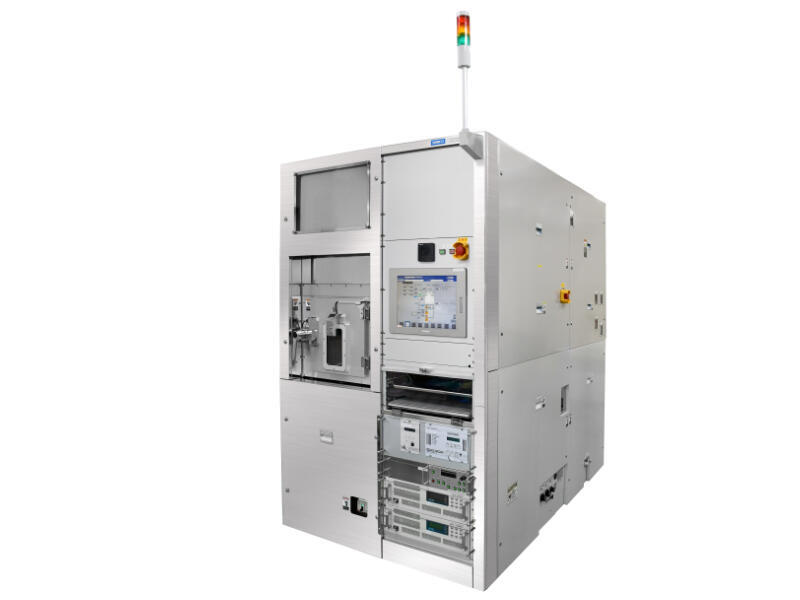
ICPエッチング装置 RIE-230iPC
⌀230 mmトレイ搬送装置
-

ICPエッチング装置 RIE-150HiC
大気搬送Wカセット装置
-

ICPエッチング装置 RIE-350iPC
⌀350 mmトレイ搬送装置
ICPエッチング装置の特徴
トルネードICP®
近年、LEDやパワー半導体などのグリーンデバイスは様々な場面で利用されています。
グリーンデバイスの材料となる化合物半導体の微細加工には高精度のドライエッチングプロセスが要求され、従来のRIE(反応性イオンエッチング)を超える高密度プラズマエッチング装置が求められています。ICPエッチング装置は、それまでの標準である平行平板型RIE装置に比べ、プラズマ密度が1000倍になる高密度プラズマが得られ、プロセスマージンを大きく広げることができます。 しかし、均一なプラズマを生成するのに課題がありました。
トルネードICP®のしくみ
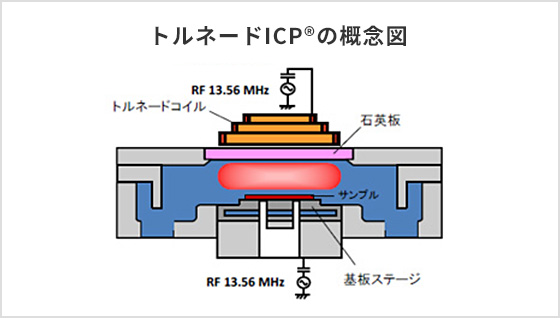
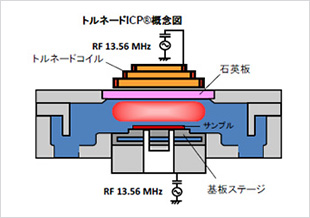
サムコの開発したトルネードICP®は、ICPエッチング装置による均一なエッチングを実現すべく、中核となるコイル部分を3次元構造にしたICPコイルです。コイル配置に自由度を持たせることで、高均一なプラズマを生成することができます。
トルネードICP®エッチング装置は、化合物半導体だけでなく、シリコンや各種金属薄膜などの、高速、高アスペクト比の異方性エッチングで高い面内均一性を実現しており、様々な分野の生産現場や研究所で使用されています。
誘導結合方式を利用
放電形式に誘導結合方式(Inductively Coupled Plasma)を採用したドライエッチング装置です。
高い面内均一性を実現
サムコのICPエッチング装置には、独自のICP ソースであるトルネードICP®コイルが搭載されています。
トルネードICP®とは、サムコのプラズマに対する豊富な知識と経験から独自開発された誘導結合方式プラズマ源です。渦巻き状に構成された特殊コイル電極が次世代プロセスに不可欠なエッチング技術を可能としました。













