原子層沉積(ALD)
原子層沉積(ALD) 是一種先進的薄膜生長技術,專為電子設備(如功率元件與射頻元件)提供無針孔且均勻的絕緣薄膜沉積能力。此技術具備多項卓越優勢:其一,在高深寬比的溝槽與穿孔結構上展現出色的共形性;其二,實現埃級的薄膜厚度精確控制;其三,基於連續且自限的反應機制,可達成薄膜組成的可調性。 Samco 公司致力於提供高效且靈活的 ALD 解決方案,包括開放式負載 ALD 系統與具備負載鎖定機制的 ALD 系統,以滿足多元的產業需求。
-

原子層沉積(ALD)設備 AD-10P
原子級控制薄膜厚度
-

原子層沉積(ALD)設備 AD-800LP
適合沉積電子元件用的絕緣膜和鈍化膜
電漿輔助化學氣相沉積(PECVD)
電漿輔助化學氣相沉積(PECVD)是利用反應氣體轉爲電漿狀態時,所產生的活性基及離子的在基板上的化學反應形成薄膜的技術. 使用在化合物半導體及砂半導體製程上的氮化矽的保護膜(SiN) 及界層絕緣的氧化矽膜(SiO₂)的沉積.
-
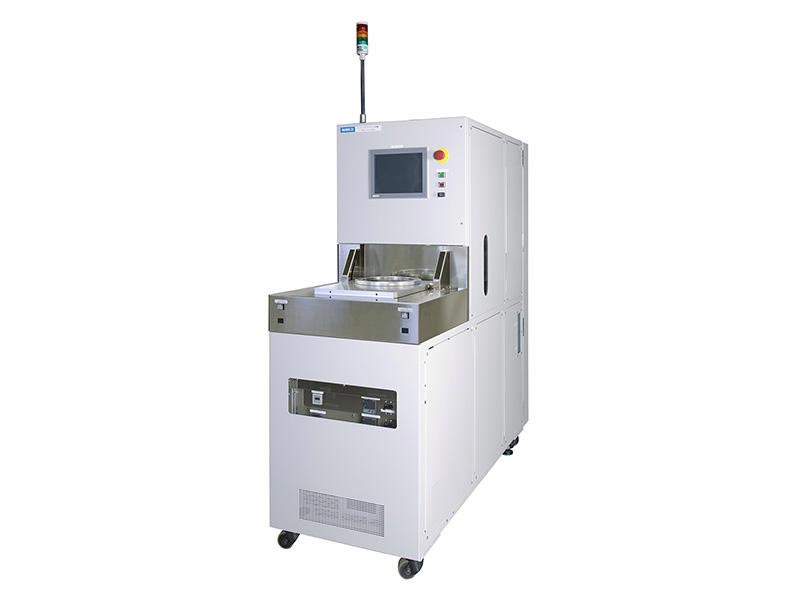
電漿輔助化學氣相沉積(PECVD)設備 PD-220NL
適合研發用途,具有晶圓搬運腔體的精簡型設備
-

電漿輔助化學氣相沉積(PECVD)設備 PD-2201LC
可對應晶圓承載盤 (cassette) 的量產型設備
-

電漿輔助化學氣相沉積(PECVD)設備 PD-3800L
多片晶圓處理設備
液態源沉積
液態源化學氣相沉積(CVD)系統是專爲R&D及小規模生產的低溫(80 ~ 400°C), 高速率(>300 nm/min) 電漿輔助化學氣相沉積系統(PECVD). Samco獨特的LSCVD系統採用自給偏壓沉積技術及TEOS進行沉積SiO2. 薄膜應力小,且膜厚能從薄到極厚(up to 100 µm).
-

液態源沉積(LSCVD)設備 PD-200STL
對應8吋晶圓的研發型設備
-

液態源沉積(LSCVD)設備 PD-270STLC
具有晶圓裝卸腔體的量產型設備
-

液態源沉積(LSCVD)設備 PD-330STC
可處理ø300mm晶圓
類鑽石碳膜沉積(DLC)
類鑽石碳膜(DLC)是一種利用電漿輔助化學氣相(PECVD)於基板上沉積DLC膜的製程. Samco的DLC膜製程可以利用離子的高能量沉積極精密的膜. 這種膜有高阻隔的效能.
-

類鑽碳膜(DLC)沉積設備 PD-100D
類鑽碳膜(DLC)專用的沉積設備






















